
SiP系统级封装集成技术
IC功能的进一步扩展通常伴随着IC结构的缩小,这一概念由Gordon Moore首先提出,从那以后就被称为“摩尔定律”。但现在IC结构已经缩小到5nm以下,制造这种结构所需的成本和难度已经阻碍了进一步扩展IC的功能。解决方案似乎是将IC晶片组合在同一块基板上形成系统级封装(system-in-package,简称SiP),这种结构也称之为异构集成(heterogeneous integration,简称HI)。
异构集成
半导体晶体管的体积不断缩小,于是人们也发现了成本更低的方式——将体积较大且结构复杂的晶片分解成体积较小的晶片,然后采用极其精细的线宽和线距及尺寸非常小的通孔将小晶片、模块化晶片(现称为小chiplet)、小分离元件放置在同一块有机IC载板上。通常有3种实现这种目标的架构(图1):
a. 在使用了PCB、玻纤或陶瓷材料的封装载板上放置多个IC晶片
b. 晶片和封装之间有硅或玻璃中介板
c. 封装载板中使用小型内嵌硅桥连接各个晶片和分离元件
图1:异构集成封装方案更倾向于使用这3种架构
多芯片封装
目前所使用的传统倒装芯片是球栅阵列封装(图2)。这种结构是在传统高性能HDI基材(1+2+1)上添加1~2层ABF膜(Ajinomoto build-up film,简称ABF)。新的ABF工艺使用耐高温RCC(通常为聚亚酰胺)材料,可承受温度更高的组装工艺(见图3)。
图2:双面模塑球栅阵列使用了ABF和高性能HDI
图3:博锐电路ABF+RCC的新制造工艺
硅中介板
HI的复杂程度日益增加将为载板增加更多功能,形成如图4所示的模块,其中包含各种材料/连接方式的IC芯片、埋入元件、RF/天线、光波导甚至能量存储。
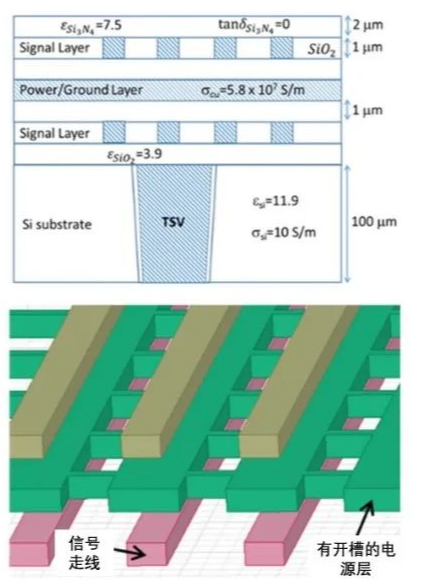
图4:硅中介板具备CTE及密度优势,但对于TSV而言成本会增加
埋入式多晶片互连桥
Intel公司提议在载板中使用埋入式多芯片互连硅桥接(embedded multi-die interconnect bridge,简称EMIB),可以在实现所需中介板互连密度的同时降低IC载板的成本(图5),于是第三种结构应运而生。
图5:EMIB能使传统多芯片封装载板达到高成本硅中介板所能达到的晶片间密度
表1和图6比较了这3种HI封装的优缺点。

图6:3种HI封装结构的5大特点

表1:3种HI封装的优缺点对比
表2和图7对比了材料的频率性能。LCD中显示器使用玻纤作为硅的主要替代材料。
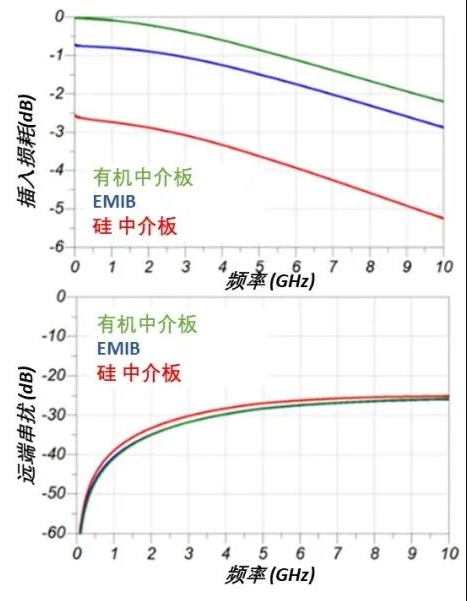
图7:3种封装的频率性能

表2:IC载板替代材料的结构和特点
总结
针对新型异构集成系统封装方案所进行的探索才刚刚起步。这项技术的基础是目前正在使用的FCBGA、硅中介板和2.5D封装方案,但更侧重于降低成本、提高性能以及可用性。